
El sistema EasyTube 3000® de First Nano es la más avanzada herramienta de configuración química de deposición de vapor/recocido para la síntesis de nanomateriales, deposición de película delgada y recocidos.
El EasyTube®3000 es capaz de sintetizar una gran variedad de nanoestructuras y de película delgada incluyendo SW/MWCNT, grafeno, nanocables tales como Si, Ge, ZnO, GaN, BN, y de película delgada tales como Si, SiO2 y Si3 N4 utilizando combinaciones seleccionadas de hidruros, líquidos y/o precursores sólidos.
Los sistemas pueden procesar de forma segura los productos químicos más pirofóricos y tóxicos, incluyendo silano, germano, diborano, fosfina, HCl, y precursores orgánicos de metal.
EasyTube 3000EXT
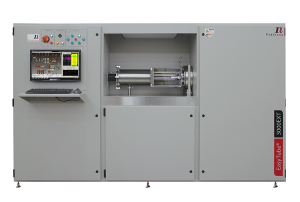
El modelo EasyTube® 3000EXT tiene un tamaño ampliado para dar cabida a los módulos del sistema de mayor tamaño.
Estos pueden incluir una caja de guantes, carga cerrada, un horno para rápido calentamiento y enfriamiento, un generador plasma de RF, y una opción para aumentar el ID de la cámara de proceso hasta 200 mm para acomodar obleas de 6”.
CONFIGURACIÓN ESTÁNDAR
- CVD WinPrC™ software de control de procesos basado para el Control de Tiempo real de proceso, registro de datos, generación de recetas y edición.
- Recetas pre programadas para una amplia variedad de aplicaciones.
- Horno de Resistencia con 3 zonas que alcanzan temperatura de hasta 1.100 °C.
- Tamaños de Oblea hasta 100 mm.
- Alto Rendimiento con Horno FastCool™.
- Proceso de control de temperatura en tiempo real patentado.
- Carga/Descarga del sustrato automática del sistema.
- Cámara de reacción de cuarzo de 5′′.
- 4 Líneas de gas UHP de con controlador de flujo de masa.
- Advertencias y alarmas de usuario configurables.
- Aplicación de sistemas de seguridad configurados.
- Software y Hardware de Seguridad Integral enclavamientos.
- Un (1) año de garantía.
- Compatible con Semi–S2/S8 y C.
OPCIONES
- Horno multizona con control de temperatura en tiempo real patentado.
- Resistencia de calentamiento de alta temperatura del horno a > 1200 °C.
- Calentamiento por Infrarrojos (IR) para procesamiento térmico rápido.
- (RTP) > 1100 °C.
- Inducción (RF) de calefacción para temperaturas de proceso a > 1500 °C.
- Operación de baja presión (100-700 torr), <50 mtorr de presión base.
- Ultra Alto Vacío (UAV) para la cámara cerrada y/o la cámara de proceso.
- Carga cerrada para mantener la integridad del tubo de proceso y seguridad adicional.
- Sistema de transferencia HotLoad™.
- Guantera con N2 exhausto o purga de Ar.
- Kit de suministro precursor de vapor líquido.
- Kit de suministro de Vapor de fuente sólida para el crecimiento de óxido y nitruro de nanocables.
- Horno de laminación.
- Plasma Ascendente (ET3000EXT).
- Crecimiento asistido de campo de polarización DC.
- Tamaño de Oblea hasta 150 mm.
- Rotación de la oblea para mejorar el crecimiento uniforme.
- Hasta 12 líneas de gas UHP de flujo masivo controlado.
- Intercambiador de aire a agua para agua de enfriamiento.
- Analizador de Gas Residual.
- Gabinetes de Gases Peligrosos EasyGas™.
- Paneles de gas para argón, nitrógeno, helio, oxígeno EasyPanel™.
- Sistema de Acondicionamiento de Gas EasyExhaust™.
REQUERIMIENTOS DE INSTALACIONES
- Eléctrico: 208 VAC, Fase 3, N, G 40 – 60 A.
- Dimensión: 96″/ 119″ Longitud, 33″ Anchura, 70″ Altura.
- Escape: 500 cfm.
- Agua De Refrigeración: 2 gpm 50-75 psig.
- Suministro Neumático: Aire limpio o N2, 80 psig.
- Instalación de Nitrógeno: 20 slpm 20 psig.
- Gases de Proceso: Especificado por el Cliente.
- NOTA: Variación eléctrica según el país; los requisitos instalaciones varían con las opciones del sistema. Consulte a la fábrica para obtener más información.











